
ICS 13.040.35
C 70
GB/T 36306—2018
Cleanrooms and associated COntrOlled environments— GUideIineS for airborne ChemiCaI COntaininatiOn COntrOl
2018-06-07 发布
2018-10-01 实施
附录A (资料性附录)微电子和光电子领域对空气化学污染物的分级与分类
, ⅜x ■ ■—ɪ-
刖 吕
本标准按照GB/T 1.1—2009给出的规则起草。
本标准巾全国洁净室及相关受控环境标准化技术委员会(SΛC∕TC 319)提出并归口。
本标准起草单位:南京天加环境科技有限公司、苏州T.业园区嘉合环境技术T程有限公司、苏州华 泰空气过滤器有限公司、苏州市计量测试研究所、爱美克空气过滤器(苏州)有限公司、中国电子T程设 计院、苏州市恩威特环境技术有限公司、中电投T程研究检测评定中心、苏州净化T程安装有限公司、北 京希达建设监理有限责任公司、北京世源希达T程技术公司、中国标潴化协会、中天道成(苏州)洁净技 术有限公司、深圳新科特种装饰T∙程公司。
标准主要起草人:王尧、娄宇、李启东、朱兰、杨子强、蔡杰、王小兵、徐小浩、张利群、吴小泉、钱菁、 转乃军、石小苗、姜皓遐、耿文韬、吴益峰、翟传明、苏钢民、安志星、刘娜、殷晓冬。
从通风专业的角度来看空气化学污染物的特点是:
a) 颗粒度V0.01 μm通常在0.2 nm〜5 nm的范围;
b) 在通常状态下是以蒸汽或气体状存在;
C)可以完全穿透常规高效过滤器/超高效过滤器;
d)不能使用粒子计数器检测。
目前•,空气污染控制技术主要针对微电子、光电子领域。
国际半导体设备与材料协会的标准SEMI F21-95将空气化学污染物分成四大类:酸性气体、碱性 气体、气相可凝聚化合物和气相掺杂化合物。但即使同类中的不同污染物之冋性质差别还是很大,某些 污染物的浓度可随环境的温度、湿度变化而改变以及污染源有很大的随机性等,且品种、数量之多已是 不胜枚挙。巾于改性活性炭技术的进展,对「很多污染气体巳能达到对症下西,实施针对性的控制空气 化学污染。在应用中,供应商提供的不仅仅是化学过滤器,而是根据现场环境的特点提供最有效的解决 方案。准确提供洁净室及相关受控环境中污染气体的品种和浓度的水平,将为过滤器供应商更合理的 选用充填介质的配方及配比创造条件,控制环境中的化学污染物达到所在环境限定的浓度值,最终将取 得更佳的净化效果。
Il
洁净室及相关受控环境 空气化学污染控制指南
1范围
本标准提山了洁净室及相关受控环境的空气化学污染控制的检测、控制等指南.
本标准适用r微电子.、光电子工厂以及特殊需求的生产、研究等洁净室及相关受控环境的空气化学 污染控制。
本标准不适用「•核能和军事应用。
2规范性引用文件
下列文件对」•本文件的应用是必不可少的。凡是注H期的引用文件,仗注H期的版本适用于本文 件,凡是不注H期的引用文件,其最新版.本(包括所有的修改単)适用[•本文件,
GE/'1' Ξ5915τ8-2010 洁净室及相关受控环境第呂部分:空气分子污染分级(150 14644-8: ZOO6 JDT)
3术语和定义
下列术译和定义适用「本文件.
3.1
空气分子污染 airbme IlIOleCUlar COntam inadoπ ; AMC
以气态或蒸汽态存在「洁净室及相关受控环境中:可危害产品.,tzj⅛■&的分子(化学的、非颗粒) 物质.不包含生物大分子。
注:空气分•户汚染即空气化学汚染.
3.2
环境反应监测法 environmental response InOnitOring methods;ERMS
综合监测腐蚀性气体对芯片的腐蚀程度的方法。
注:将环境反应采样片CERCS)⅛t在各个待测区域,•如新地机组的进出循环风机组进出口等,时间是以30天为 ■个周期,观察釆样片厚度的变化,以λCΛπg≡trcm)为单位"
3.3
污染物 Cnntalnman t
能对流体的预期使用产生负面影响的物质(固体、液体和气体工
3.4
气相空气净化装置 gas PhaSe air dtancr device; CJPΛCD
能去除特定的气体和蒸汽等气相汚染物的组装设备,
注:在本标應屮即化学过滤器,化学辻滤器属于气相空气净化装置的一种“
3.5
空气化学污染 air Ch«mical contamination
气相的非颗粒物质,其化学性质対产品、生产T一艺或设畚产生不利的影响。
GB/T 36306—2018
4汚染源.,分级与分类
4.1污染源
4.L1室外环境的空气污染物:SOO^NH^H2S.HCl等。
4.L2作业人员携带:汗水(NHK离子.,PVC手套、香水、发胶等,
4.L3制程逸散:制程化学原料——光刻胶、清洗剤、显影剤、去.光阻剂、特气泄漏等.
4.L4洁净室用材“释气財■□设备泄漏:除料、各类密封胶、期料材质、机台维修等。
4.2分級与分类
4.2J 一般的分级见 GE/'Γ Ξ5915τB-3010 中表 K
422微电子加光电子领域的分类勺分級参见附录A.
5 检测
5.1単项污染物检测参见附录B中氏丄、氏n
5.2环境反应监测法(ERMS)參见IU,
注、E是茶取较长时何的取样方法,通过检测判定分子污染餘台影响"
6空气化学汚染控制
6.1确定是否污染及情况
定性确定是否有空气化学污染。如有:需分析测定污染物的类型:和浓度范围。
6.2控制措施
6.2J釆用化学过滤器并根据污染物和控制目标,对空气化学过滤器的过滤介质(如活性炭、改性活性 炭等)的有效性.、装填密度,过滤器的设计、加工的优劣(防止沟流)等进行分析并选择.
注:化学过滤器的性能及.橙測•参见GK/T 36370-2018 *
6.2卫 实时监测化学过滤器的出风口:如遇出风口气流中污染物浓度超出规定的标准则应立即更换.
注:空气化学过滤器使用寿命通常为-•年,该指标是在标准指定试验条件下测定的结果,与实际使用条件右偏差, 只能 作为毒考.
523控制化学分子污染设施系统参见附MCo
524微电子丁业洁净室空气化学污染控制参见附录【孔
GB/T 36306→018
附录 A
(资料性附录)
微电子和光电子领域对空气化学汚染物的分級与分类
微电子利光电子领域常见空气化学污染AMC的分级、分类见表A.L,表A.2。
注】参照半导体•殴备与材料学会SEMl F21-1102标准“
表A.1四美汚染物浓度分级
|
汚染物神类 |
1 |
10 |
IoO |
1 QOo |
10 QOO |
|
酸类 |
MA-I |
MΛ-10 |
MA-I(W |
MA-JOOO |
MA-IOQOO |
|
成类 |
MEH |
MB-IO |
MMQO |
MB-JOQQ |
MB-IOOOO |
|
町凝聚物 |
MC-I |
MC-IO |
MC-IOQ |
MC-IooO |
MC-IOOoO |
|
掺.物 |
MD-I |
Ml)-Io |
MD-IOO |
MD-IoQO |
MD-ICQQo |
|
注,池度为PPtM | |||||
表A∙2各类空气化学污染物的代表性化合物
|
SEMI h,21-1102 AMC 分类 |
重要,粗分r∙汚染物 |
|
酸类 |
萱氟酸,疏酸,盐酸,硝媵,礎酸,氢浪酸 |
|
磁类 |
氫气/旬氧化铉),四甲基氫籁化膛"甲基胺, :.乙基胺,N-甲基毗咯焼酮,环己胺, 二乙氫基乙菖,甲基胺,二甲基胺,乙I?胺* 1 η 4-¾M六环 |
|
祖翻聚化合物类 |
硅油< 沸点>150 0 碳氢化脊物(■沸.⅛>15∩笆) |
|
參柴物类 |
MK滴常如硼酸), 红磷〔通常如冇机麟酸酯L 碑(而常•如珅陶盐) |
GB/T 36306—2018
附录 B
(资料性附录) 气相污染物监测与相关分析测定便器
B-I分析测定技器概述
単一的分析仪器不能测定本标准所涵盖的所有品种,分析测定设•备应根据汚染物的特性仔细选择. 同样,釆样和探测器以熒测是设备的精度廂有效的测定星程,可以在很大程度上变动。
SEMl F2J-110Ξ(200Ξ版)标准:把气相化学污染物分成四大类:酸美:通常选用SQ为代表。诚 类,通常选用NH:,为代表,可凝聚有机化合物,通常选用甲苯作为Yg 代表.揍杂化合物,通常磷 选用有机麟酸酯,硼选用HF』等为代表.
针对上述测定的要求,推荐的方法包括:气相色谱(GC-FHXGC-Ms)用j••对有机物测定,化学发光 法(CLD)用「测定N0,和氨气,紫外荧光光度法(UVL)用「测定S0,电感耦合等离于体-质谱仪 QCP-MS),是一种多元素分析议,分析对象可从超痕量到基題组分、从H1&/L到pg∕L(微微吏7升)的浓 度范围,甚至号称可达到覆盖周期表的无干扰测量。傳立叶变换红外光谱仪(FT]R)能在校大的范围内 使用.
在某些特定的情况下,F1[)在线检测不可能达到实际要求釆用的很低的浓度:即崟一个在线FTD 检测器的有效量程达不到下游的采样浓度时:应使用易地设备,如用TenaX管配合GC-MS/FID或气体 吸附管配合离子色谱等均可采用。
B-Z几种气相汚染物常用分析测定愼器及应用简介
K21化学宏光(CLD)分析悦:测定NO.NO⅛、NQ,、NTI,
化学发光是指在某些特殊的化学反应中:反应的中间体或产物由于吸收了反应释放的化学能而处 「电子激发态其回到基态时伴随产生的光帶射现象.根据化学发.光反应打某一肘刻的发光强度或 反应的发光总量来确定反应中相应组分含星的分析方法,称为化学发光分析。
化学发光法的原理表达式見式(KD、式(R2):
No+Ch → NOi + Os ..............................< BJ )
NchfNCh+hr ..............................( R2 )
'或仪器有3种模式:
心 NO模式:当气样中的NO^OS (⅛氣)反应生成N(λ吋:大约有10%的N3处于激化状态 (以NO2表示兀 这些激发态分子按式(KN)向基态过渡时:发射出波长59OrmI〜N 500 tιm的 光量子其强度与ND量成止比.利用光电倍增管将这一光能转变为电信号输山可推算出 NO ⅛度.
b) N0.模式,样气首先进入N(Z转换装置,样气中的N0,包括NO NO2 :■其中的Nd在此 转换成N。•全部的Mo经反应、检测,籀出一个正比J; NO..的直流电流,数字而板表显示 NO.,的浓度。rtlNCL的浓度减去NO的液度就可得到可贝 的液度c.
C)总氣(Nt)模式:样品经过一个不锈钢转化炉,NO3.NHs都将被转化成N(丄此时测量的是总
GB/T 36306—2018
M(Nt),包括:NO+NO2÷NH.:减去前一者即为MHH。
化学发光分析仪仪器规格见表氏虬
表111化学发光分析快使器规格
|
预置量程 |
0—0.05XIoT ,0.1×IOf ,0.2X10' ∖Q.5×Iof τl×lQ'∖2×10^∖5×lQ 5,1。XloT J^O×10^' O*-Q.l mg/tnJ τ0.2 mgʃʃm' τQ.5 Ing/ tn' +1 mg/tn, >2 πιg∕τ∏` TS Tng∕m' JIO mg∕tn, T£口 mg∕fπ, T 30 mg∕ tn1 |
|
扩展蛾程 |
0—0.2X W-h ,0.5XlC H- TI X W-h T^XIO hτ5XKr%loχlo ∖2Q×1O ^50X10' MOOX10'h 口〜0.5 mg∕tn' 11 mg∕fr'' T£ mg∕(π'' ,5 mg∕tn1 J 1.0 ITLg∕tπ∣'' τ2D IllIg/tn' ,5。ITLg∕m'' TIoO Ing∕tπ'' η 1 时 ing/tɪɪ' |
|
密点噪音 |
0.50X10 ∙fl RMSCl20 S F均时间) |
|
最低检测限 |
1.0X10 ■- (120 S平•均时间)最低检溯液度应低于现场可能的最低池度 |
|
零点滇移擇4 h) |
<1×1Q^1 |
|
躇度漂移34 h) |
士 1*满量程 |
|
响应时间(□%〜吋%〉 |
120 S(IO B平均时间) |
|
精度 |
±Q.4×10^πC量程 5CO×1Q^1) |
|
线性 |
丄1%满量程 |
|
釆样流R |
0.5 IJtnin |
|
「作温度 |
15 *~35 笆 |
|
输出 |
可选电压,R溢3"'RS1%, TCP∕IΓt 10个状态堪电器,断电指示 0 πιΛ^20 mʌ 或 4 rnΛ^2θ mʌ 隔离⅛⅛⅛⅛ JL |
|
输入 |
16路数字输入〔标飛〉渦路O-IQ VDC僚振铀輸入 |
B.2.2紫外黄光光度法(UVLL测定SO2UIiS
脉冲紫外荧光法气体分析仪,是用「—氧化硫和硫化氢测定的分析仪器.其操作原理是,首先把 HzS转化成Sa进行测定,巾I'-SO2分子吸收紫外(UV) Jt并杠某一特定波长上被激发:当Sa分子 衰减到较低能级时会发射出另一种波长的紫外光。原理表达式见式(Iu)、式(Iu):
H=SfSQ ..............................(Iu)
SO2 ÷hυ1 ^SO3 * f h毛 ..............................(BΛ )
.眛冲紫外光源可提高光强,使仪器具有校高的紫外光能星,从而降低最低检测极限.相关标准和依 据:本方法主要参考1S0/CD ]049S.
紫外荧光.光度法(UVL)分析仪规格見表B,2e
表B.2紫外荧光光度法(UVL)分析仪规格
|
预置旺程 |
0—0.05× 10"S0.1 ×10~b,0.2×10"5>0.5×10"5,l×10"β5,2×10~%5×10~%10×10~fi 0〜0.2 tng∕m', 0.5 mg∕m', 1 mg∕m', 2 mg∕m', 5 mg∕m', 10 tng∕tn5 > 20 tng∕tn', 25 mg∕ tn? |
|
扩展任程 |
0〜0∙5X10-fi, IXIof, 2X10-6, 5Xl(Γfi, IOXIo-% 20X10"% 50Xl(Γfi, IOOXlOf 0〜2 mg∕m', 5 mg∕t∏S 10 tng∕m', 20 tng∕m', 50 tng∕m', 100 tng∕m', 200 tng∕t∏S 250 tng∕ tn^ |
|
用户旺程 |
0〜0∙05X10f 至 IOOXlOi 0〜0.2 mg/tnS 至 250 mg∕tni |
|
零点噪音 |
手动模式LoXlOi(IO S平均时间),0.5X10-,(60 S平均时间),0.25×10'5(300 S平均时间) 自动模式3.0×10'5(10 S平均时间),L5X10T(60 S平均吋间),0.75×10'5(300 s平均时间) |
|
最低检测限 |
手动模式2.0×10^∖10 S平均时间),LOXlOf (60 S平均吋间),0.5乂10一’(300 s平均时间) 自动模式6.0X10*10 S平均时间),3.0×10"5(60 S平均时间),1.5XIO'5(300 S平均时间) 最低检测浓度应低于现场可能的最低浓度 |
|
零点漂移(24 h) |
<1X10-, |
|
跨度漂移(24 h) |
士 1%满信程 |
|
响应时间(0%〜90%) |
80 S(IO S平均时间)或110 s(60 S平均时间)或320 s(300 S平均时间) |
|
精度 |
1%读数或1 Xlof(以较大值为淮) |
|
线性 |
士 1%满信程 |
|
采样流品 |
1.0 L/tnin |
|
转化炉效率 |
HZS转化为SO2>80% (注意:其余毓化物也会被不同程度的转化) |
|
T作温度 |
20 P〜30 P |
|
输出 |
可选屯压,RS232∕RS485,TCP∕IP,10个状态继电器,继电指示0 mA〜20 mA或4 mA〜20 tnA 隔离电流输出 |
B.2.3电感耦合等离子体发射光谱仪(ICP-OES)测定金属原素及部分非金属元素
在近代物理学中,把电离度大于0.1%电离气体,都称为等离子体(PIaSma),也即电子和离子浓度处 于平衡状态的电离气体。“等离子矩”就是由等离子体形成的“电火炬气电感耦合等离子体矩是利用高 频感应加热原理,使流经石英管的工作气体(通常为Ar)电离而产生火焰状的离子体。
“等离子矩”火焰温度高达4 000 K〜IOOo K,其温度取决于高频发生器的功率及I:作气体,火焰的 穏定性比较高,因而有检出限低、精密度好、动态范围宽、基体效应小、无电极污染等特点,而获得广泛的 应用。
主要特点:
a) 可以测定全部的金属原素及部分非金属元素(70多种)。
b) 高效穏定,可以连续快速多元素测定,精确度高,多种元素检出最能达到0.01 μg∕Lo
C)中心气化温度高达10 000 K可以使样品充分气化有很高的准确度。
d) I:作曲线具有很好的线性关系并且线性范围广。
e)与计算机软件结合全谱直读结果,方便快捷。
GB/T 25915.8-2010中附录B所列出的掺杂污染物如:硼、磷、神等污染物的定性,定量分析,所推 荐的测定方法中如釆用ICP-OES测定,相应的检出极限各为:≡(B)O.69卩g∕L,磷(P)1.55卩g∕L,砰 (AS)1.43 μg∕L均能满足应用。
B.3洁净室常用的环境反应监测系统
B.3.1概述
洁净室环境中污染物的测试是污染控制的重要部分,10多年来已积累了大量有成效的结果。空气 化学污染物虽然已划分为四大类,但品种、数量之多已是不胜枚举,并旦有时是不稳定的,如果采用化学 仪器分析并不是一件很简単•的事。并旦在实际中感到,単.一气体影响与多种气体同时共存的情况,对芯 片影响的程度可能产生协同效应,单.项污染物测定数据无法表明这种可能的协同效应所造成之影响。 因而,在1999年以后在ISA S71.04—1985的基础上建立了“环境反应监测法W(ERMS)逐步得到发展, 取得成功,该方法是考虑腐蚀性气体对芯片的腐蚀程度为基础,采用环境反应采样片(ERCS)放在各个 待测区域,如新风机组的进出口,循环风机组进出口等,时冋是以30天为一个周期,观察釆样片厚度的 变化,以A(AngStrOm)为单位。
B.3.2洁净室的环境分级
根据ERMS的分级标進各分5级,用CI〜C5、SI〜S5来表示不同的程度,见表33。
表B.3洁净室环境分级表
|
级别 |
钢腐蚀空气质量分级 |
腐蚀舟 |
级别 |
银腐蚀空气质髭分级 |
腐蚀最 |
|
CI |
纯净的 |
<90 λ∕30 天 |
SI |
纯净的 |
<90 λ∕30 天 |
|
C2 |
干净的 |
<150 λ∕30 天 |
S2 |
干净的 |
<150 A/30 天 |
|
C3 |
—般的 |
<250 A/30 天 |
S3 |
一般的 |
<250 λ∕30 天 |
|
C4 |
严酷的 |
<350 λ∕30 天 |
Sl |
严酷的 |
<350 A/30 天 |
|
CS |
剧烈的 |
>350 A/30 天 |
S5 |
剧烈的 |
>350 λ∕30 天 |
B.3.3普通洁净室验收标准
ERMS的可用于普通洁净室验收,见表34。
表B.4普通洁净室验收标准表
|
铜腐蚀的反应产物 |
腐蚀膜厚度 |
银腐蚀的反应产物 |
腐蚀膜厚度 |
|
硫化铜CBS |
0 A/30 天 |
氯化银AgCI |
0 A/30 天 |
|
氧化铜Cu2O |
<150 A/30 天 |
硫化银A&S |
<50 λ∕30 天 |
|
____未知的制____ |
0 λ∕30 天 |
范化银A织O |
<50 Λ∕30 天 |
|
总铜腐i⅛量<150 A/30天 |
__________总银廊蚀-VlOO A/30天__________ | ||
B.3.4空气化学过滤器性能一览表
采用ERMS可检测空气化学过滤器的性能,见表B.5a
表B.5空气化学过滤器性能一览表
|
ERM的监测区域 |
铜反应" |
减少 |
级别 |
银反应' |
减少 |
级别 |
|
新鲜空气进口 |
435 |
C5 |
362 |
So | ||
|
空气化学过滤器出口 |
21 |
95.16% |
CI |
9 |
97.58% |
SI |
|
机械室 |
57 |
86.97% |
CI |
28 |
92.24% |
Sl |
|
洁净室 |
11 |
97.49% |
CI |
23 |
93.62% |
Sl |
|
€ A/30 天 O | ||||||
附录C
(资料性附录)
控制化学分子污染设施系统
C.1概述
洁净室通风与空气调节系统中有关化学污染控制的部分包括:新风系统、循环风系统、微环境控制 系统和带净化装置的前端开启式晶圆传送^LFOUP(Front OPening Unified Pod)]以及移动式深层过 滤器系统等。
新风系统的控制,要求去除户外空气中化学污染物,重点是低浓度的SO2、NO,、NH'、O,及VoCS等。
循环风处理系统,是控制洁净室排出的气体,使空气化学污染物降到一定浓度后,再合并入新风系 统,该系统主要去除空气中的低、中浓度的化学污染物。
深层过滤器系统用「•去除某些局部的高浓度气相化学污染气体,当其他的系统无法经济的提供所 需要的净化处理时,釆用深层过滤器系统,满足空气质量要求。
C.2微电子行业洁净室空气化学污染的控制方案
在洁净室的 H VΛC( Heating VentilatiOn Air-Conditioning)系统(图 C.1)中,包括新风机组 MAU (Make-UP Λir Unit)和循环风机组RHU(ReCirCUIatiOn ʌir Handling Unit)应配置合适的空气化学过 滤器,在风机过滤单元FFU(FIker Fatl Unit)中配置化学过滤网以及专用化学过滤装置,以保持大环 境、微环境中合格的空气质量。此外,为了各生产T序设备维修的需要,宜设置可移动的深层空气化学 过滤器,去除局部高浓度的污染气体,否则高浓度的污染气体进入主回风系统将会使污染控制系统失 调,经济上也很不合理。
厂 A3*∙LMh.mi.∙
I -— 亠亠―1» ■丄■■
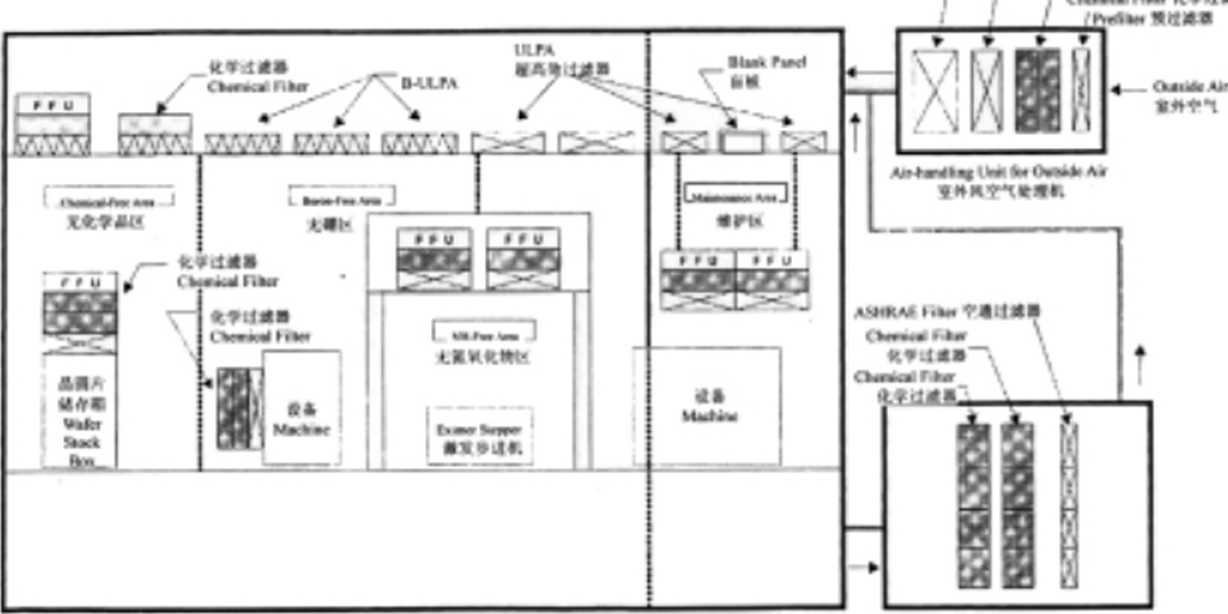
IhMtef M
∙m∙∙
注,图中室外风空气处理机(即MAU)和循环凤处理机(UlJ RHU)均省略其他功能段。
图C.1微电子生产洁净室AMC控制示意图
C.3控制空气分子污染新风机组全功能段示意
新风f进风段f粗效段f中效段f一级加热段f一级表冷段f淋水段f二级表冷段f二级加热段 f加湿段f风机段f缓冲段f化学过滤段f中效过滤段f高效过滤段f出风段f送新风,共15个功能 段(示意图见图C.2)。


注1:甘前微电子洁净室净化空调新风机组除凤机段外,有两级加热、两级表冷、五级过滤(初效、两级中效、高效、 活性碳)、一级淋水、一级加湿共15个功能段”
注2:风机的全斥高达2 500 Pa。机外噪声- •般小于80 dB(A),出曰噪声高达100 dB(A)°
注3,淋水和活性碳化学过滤器对化学(分子)污染均有一定的去除能力。但一些酸性物质被淋水吸收后又很快地 分解,达不到去除的目的。活性碳化学过滤群对化学(分子)污染吸附能力很好,其去除效率在70%以上。但 此时空气的相对湿度不宜太高,小于70%。
注4:高效过滤器后面空气的洁净度等级为ISO 5级。
图C.2新风机组功能段示意图
C.4微电子洁净室用风机过滤器机组(FFU)
微环境控制系统,主要为一些局部环境的特殊需要而设计(FFU配化学滤网见图C.3)o


注1:微电子洁净室用风机过滤辉机组由凤机、高效过滤器(超高效过滤辉)、化学过滤將组成。纤維型活性碳过滤 器的阻力宜为30 Pa同时要更换方便,又对高效过滤器(超高效过滤器)不产生二次污染。
注2:机组年外余不大于120 Pa,单台机组的山曰噪声宜小于54 dB(A),0.45 π√s°
注3,高效过滤器后的断面平均风速及断面风速的均匀度为0.45 m∕s,±20%°
图C.3带有化学过滤网的风机过滤器(FFU)结构图
附录D
(资料性附录)
微电子工业洁净室空气化学污染控制标准
D.1各类污染物在不同生产过程的控制标准
集成电路晶片生产的加TT序已逾数百个独立T序,确定空气化学污染物控制指标更为复杂。因 为分子污染物的控制对不同的产品、不同的TZ、不同的T序及不同的T艺材料会有不同的要求。
semλtech研究了各种空气化学污染物对线宽o.25 `m产品合格率的影响,发现不同空气化学 污染物对不同的工艺过程影响程度很不一样。1995年其发布了在线宽0.25 μm时各制程AMC的浓度 限定(表
表D.1 SEMATECII预测在线宽0.25 μm时各制程AMC的浓度限定
|
丁.艺步骤 |
最长停留时间 |
MA” |
MEr |
MC |
Mry |
|
预“门范化” |
4 h |
13 000 |
13 000 |
1 000 |
0.1 |
|
沉积 |
1 h |
180 |
13 000 |
35 000 |
1 000 |
|
触点形成 |
24 h |
5 |
13 000 |
2 000 |
100 000 |
|
深紫外光刻 |
2 h |
10 000 |
1 000 |
100 000 |
10 000 |
|
注:SEMATECH , SemiCondUCtOr Manufactxiring TeChnOIOgy 半导体制造技术(战略联盟)。 | |||||
|
λ浓度为PPtM级。 | |||||
D.2 ITRS发布的控制标准
1999年ITRS发布了对F 0.25卩m〜0.10卩m线宽产品的生产环境空气中AMC浓度的要求 (表 D.2)。
表D.2 ITRS对不同线宽制程污染物控制标准
|
污染化合物类型 |
_______________集成电路的儿何线宽________________ | |||
|
0.25 μm |
0.18 μm |
0.13 μm |
0.10 μxn | |
|
VoCS/(倒謂) |
30.00 |
10.00 |
3.00 |
1.00 |
|
高子化合物/(*g∕∏√) |
1.00 |
0.30 |
0.10 |
0.03 |
|
总碳氢化合物 |
10.00×10"λ |
3.00X1OT |
LoOXIOi |
0.30×10^a |
|
金属(PPtM) |
0.10 |
0.03 |
0.01 |
0.00 |
注:ITRS(InternatiOnal TeChnOIOgy ROadnlaP Semiconductor)国际半导体技术路线图。
D.3 ITRS微电子行业洁净室AMC控制的发展
D.3.1 AMC的控制概念随生产、T艺技术的更新,控制概念也在不断的更新,表D.3〜表D.5是ITRS 分别于2001年、2003年和2005年提出的对于晶片环境污染控制的技术要求。
D.3.2 2001年ITRS正式提出“对「短时冋和长时间晶片环境污染的控制(WECC)的技术要求”,见表 D.3。在这一时期前后对于洁净室分子污染的控制概念是把“整个洁净室看作是晶片环境气
表D.3 2001年对于晶片环境污染控制的技术要求
|
___________气载分子污染物___________ |
______短时间/长时间的限制值(PPtM)______ |
|
_________光刻一■(如,胺、胺化合物、氨)_________ |
750∕<750 |
|
柵极一金属(如,铜) |
0.2/0.07 |
|
________捌极一有机物(如,分子最2250)_________ |
100/20 |
|
有机物(如,甲烷) |
1 800/000 |
|
________硅化金屈淀积接触一酸(如,C「)________ |
10∕<10 |
|
硅化金属淀积接触一成(如,NH,) |
20∕<4 |
|
____________掺杂物(璘或硼)____________ |
<10∕<10 |
D.3.3 2003年ITRS对「AMC控制进一步提出了技术要求,原则上仍然认为“晶片环境就是整个洁 净室环境”,但是提出了一些重要的改变,就是空气中的AMC浓度与沉积在晶片表而上的AMC(SMC) 称为表面分子凝聚物的有很大不同,见表D.4。
表D.4 2003年对晶片环境污染控制的技术要求
|
空气中气载分子污染物 |
短时间J长时间的限制值(PPtM) |
|
光刻一敏(如,胺、胺化合物、氨)_____________________ |
750∕<250 |
|
栅极一金属(如,钢) |
0.15∕<0.07 |
|
捌极一有机物(如,分子tt≥250) |
80/20 |
|
有机物(分子ft≥C7Hu) [与标淮十六烷(CMHU)相当的]____________________ |
5 000∕<2 500 |
|
硅化金属淀积接触一酸(如,HCI) |
10∕<10 |
|
硅化金屈淀积接触一敏(如,NHQ_________________ |
12∕<4 |
|
掺杂物(璘或硼) |
<10∕<10 |
|
气载分子污染物,表面沉积的限制[硅晶片沽净度(Si WitneSS Wafer) ,24 h S露丁密闭的FOUP,POD,微环境或空气中] |
短时间/长时间的限制值(∏g∕cm2) |
|
品片上的有机物SMC ASTMI982-99 |
_____________________4/1_____________________ |
|
前端丁・艺过程,裸露Si,24 h在试验硅晶片表面的总掺杂物髭 原 子 ½∕cm2 |
<2.0E+12∕1.0E+12 |
|
前端丁・艺过程,裸露Si,24 h在试验硅晶片表面的总金属髭 原子 数/cπ√_______________________________________________ |
<2.0E+10∕1.0E+10 |
D.3? 2005年ITRS面对*时半导体集成电路行业三项重要进展(进入几何线宽65 nm以下各代器 件;直径300 mm的晶片;CUT.艺)提出了 AMC的新控制方案。晶片制造、处理和输送方法的自动化 程度大大提高,晶片在洁净室中的气相暴籍时冋大为减少,晶片环境已融入到微环境的空冋、T艺设备、 POD以及FOUP(前开式晶片食)的环境。WECC使用T艺流程区域来划分AMC控制等极,尝试减少 同样等级AMC控制的生产成本。详见表D.5。
表D.5 2005年对晶片环境污染控制的技术
|
在沽净室、SMIF、POD、FOUP等环境中的晶片环境控制 (不是洁净室木身必须,而是晶片环境必须) | |
|
空气中气载分子污染物 |
短时间/长时间的限制值(PPtM) |
|
光刻(洁净室空间环境) 总核性化合物(如,SO厂)包括有机酸 总诚性化合物(如,NH,) |
5 000/5 000 50 000/50 000 |
|
可凝聚有机化合物(WZGC-MS的 保留时间濟革,校淮用十六烷) |
26 000/26 000 |
|
难砥化合物(如,含硫、璘、硅的有机物) |
100/100 |
|
柵极晶片环境(洁净室.POD∕FoUP之空间) | |
|
总金属(如,铜) |
1/0.5 |
|
掺杂物(仅指生产线的前端) |
10/10 |
|
SMC(表面分子可凝聚闻) 在晶片上的有机物ng∕(cm2 •周) |
2/0.5 |
|
硅化金属淀积的晶片环境(洁净室.POD∕FoUP之空间) | |
|
总酸性化合物(如,SO厂)包括有机酸 |
10/100 |
|
暴露的铜晶片环境(洁净室.POD∕FoUP之空间) | |
|
总酸性化合物(如,SO厂)包括有机酸 |
500/500 |
|
总包化物(如,CL〉 |
1 000/500 |
|
中间掩模暴露(洁净室.POD∕ ⅛之空间) | |
|
总酸性化合物(如,SO厂)包括有机酸 |
500/TBD (待确定) |
|
总诚性化合物(如,NHQ |
2 500/TBD(待确定) |
|
常规晶片环境(洁净室.POΓ)/FOUP之空间,所有范围,除非下面说明) | |
|
总酸性化合物(如,SO厂)包括有机酸 |
1 000/500 |
|
总诚性化合物(如,NHQ |
5 000/2 500 |
|
m凝聚有机化合物(WZGC-MS的 保留时间沐革,校淮用十六烷) |
4 000/2 500 |
|
掺杂物(仅指生产线的前端) |
10/10 |
表D.5(续)
|
在洁净室、SMlF、POD、FoUP等环境中的晶片环境控制 (不是洁净室本身必须,而是晶片环境必须) | |
|
空气中气载分子污染物 |
短时间/长时间的限制值(PPt M) |
|
SMC(表面分子可凝聚闻) 在晶片上的冇机物ng∕(cm2 •周) |
2/0.5 |
|
前端I:艺过程,裸露Si,24 h在试验硅晶片表面的总掺杂物常 原 于数∕cn√ |
2.00E+12/1.00E+12 |
|
前端I:艺过程,裸露Si,24 h在试验硅晶片表面的总金属坟 原子 数 ∕cπ? |
2.00E+10/1.00E+10 |
|
注 1 : SMIF, Standard MeChaniCal Interface 标准机械接口。 注2: POD片盒。 注 3 : FOUP, FrOnt OPening Unified POd 前开口 片盒。 | |
参考文献
[1] GB/T 36370-2018洁净室及相关受控环境空气过濾器应用指南
[2] ISO/DIS 10121-1 TeSt method for assessing the PerfOrmanCe Of gas-phase air Cleaning media and devices for general VentilatiOn—Part 1: GaS-PhaSe air CIeaning media
[3] ISC) 10121-2 TeSt methods for assessing the PerfOrmanCe Of gas-phase air Cleaning media and devices for general Ventilation—Part 2 : GaS-PhaSe air Cleaning devices (GPACD)
[4] ISC) 10498 :2004 describes an UltraViOlet fluorescence method for sampling and determining SUlfUr CIioXide (SO2) COnCentratiOnS in the ambient air USing automatic analysers
[5] ISO 11155-2 :2009 Road VehiCIeS—Air filters for PaSSenger COmPartmentS—Part 2: TeSt for gaseous filtration
[6] ISO/WD 13353 2001, ROad VehiCIeS—Air FilterS for PaSSenger COmPartment—Part 2: TeSt for DynamiC GaS AdSOrPtiOn
[7] ANSI/ASHRAE Standard 145.1—2008
[8] ASHRAE 2rxl CIraft 145.MethOCl Of TeSting GaSeOUS COntaminallt Air CIeaning DeViCeS for RemOVai Efficiency"
[9] ASTM D5127-99 Standard GUide for Ultra PUre Water USed in the EleCtrOniCS and Semiconductor IndUStry
[10] IEST-G-CCO35.1: DeSign COnSideratiOnS for AMC FiltratiOn SyStemS in CleanrOOmS
[11] JlS B 9901: 1997 (E) “Gas removal-Method Of test for PerfOrmanCe Of gas-removal fil-tersv
[12] M FOrSlUnd WMOIeCUlar filtration devices-AnintrodUCtiOn”, (to be PUbliShed)
Γ13] SEMI F21-1102 CiaSSifiCatiOn Of AirbOrne MOleCUIar COntaminant LeVelS in Clean Environments
[14] TeChnOIOgy ROaeImaP for SemiCOndUCtors, YielcI EnhanCement Groups, SeCtiOn On Wafer EnVirOnmental COntaminatiOn COntrOl